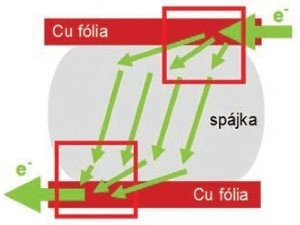
Miniaturizácia súčiastok, ako dôsledok neustálej snahy o vyššiu integráciu funkčných prvkov elektronických obvodov, vedie okrem iného k zmenšovaniu spájkovaných spojov. Menšie rozmery spájkovaných spojov so sebou prinášajú aj ich vyššie namáhanie elektrickým prúdom, keďže dochádza k nárastu prúdovej hustoty v spojoch. V spájkovaných spojoch sa toto zvýšené namáhanie prejaví okrem ohrevu najmä elektromigráciou, t. j. presunom materiálu spoja a tvorbou dutín. Spolu s nárastom intermetalickej vrstvy na rozhraní spájky a spájkovacej plôšky to významne ovplyvňuje spoľahlivosť a životnosť spájkovaného spoja. Pri dlhodobom pôsobení vysokej prúdovej hustoty môže byť tvorba dutín taká výrazná, že v konečnom dôsledku dôjde k úplnému prerušeniu spoja ako elektromechanického prepojenia, čo má za následok čiastočné alebo úplné znefunkčnenie elektronického zariadenia.
Elektromigrácia v oblasti elektroniky predstavuje najmä presun materiálu spájkovaného spoja v dôsledku zvýšeného dlhodobého namáhania jednosmerným prúdom. Toto namáhanie môže spôsobiť výrazné zmeny v mikroštruktúre spájkovaného spoja. Najčastejším prejavom elektromigrácie je tvorba dutín a zvýšený rast intermetalických zlúčenín na rozhraní spájka a spájkovacia plôška dosky plošného spoja (obr. 1). Elektromigrácia je degradačný proces skracujúci životnosť zariadenia [1].

Obr. 1 Nárast hrúbky vrstvy intermetalických zlúčenín Cu3Sn a Cu6Sn5 v spájkovanom spoji ako dôsledok elektromigrácie pri zaťažení prúdom 4,12.104 A.cm-2 [2]
Pri vysokom prúdovom zaťažení sa dutiny v spoji tvoria na strane zápornej elektródy a prenesený materiál spájkovacej zliatiny sa hromadí na strane kladnej elektródy, anódy. Tento jav je teda spôsobený tým, že materiál je tokom elektrónov unášaný k anóde a na strane katódy sa vytvárajú dutiny po chýbajúcom materiáli. Proces tvorby dutín výrazne ovplyvňuje spoľahlivosť a životnosť spájkovaných spojov. Tým, že sa v spájkovanom spoji tvoria dutiny, ešte viac narastá prúdová hustota, čím sa podstatne urýchľuje proces degradácie.
V homogénnej štruktúre kovu (Sn alebo intermetalické zlúčeniny v spoji: Cu6Sn5, Cu3Sn alebo Ag3Sn) je v dôsledku rovnomerného usporiadania iónov kovu v kryštalickej mriežke prenos hybnosti (schopnosti pohybovať sa) medzi usmernenými elektrónmi a iónmi kovu energeticky náročný, keďže ióny kovu sú pevne usadené vo svojich polohách prostredníctvom kovovej väzby. No v prípade hraníc zŕn tej istej kryštalickej fázy, rozhraní medzi rozdielnymi kryštalickými fázami alebo v prípade iných porúch v usporiadaní atómov sú ióny kovu vzájomne viazané slabšie ako v usporiadanej kryštalickej mriežke, preto je prenos hybnosti medzi elektrónmi a iónmi oveľa intenzívnejší, výraznejší. Uvoľnenie iónov kovu z väzby je menej náročné na aktivačnú energiu dodanú nárazom elektrónov. V prípade, ak elektrický prúd dosiahne dostatočne vysokú hodnotu, presnejšie hustotu, spôsobuje to oddelenie atómov (iónov) zo vzájomnej väzby. Tieto kladné ióny sa následne pohybujú v smere toku elektrónov.
Presný smer pohybu je ovplyvnený hranicami zŕn, pretože atómy majú tendenciu pohybovať sa v smere týchto hraníc, keďže kladú menší odpor pohybujúcim sa iónom [3]. Vo všeobecnosti v elektrotechnike spočíva potlačenie elektromigrácie vo výbere vhodného materiálu (napr. Cu má až 10krát vyššiu aktivačnú energiu ako Al) a vo voľbe vhodného prierezu vodivého spoja s cieľom dosiahnuť podkritickú hodnotu prúdovej hustoty. Typické prúdové hustoty, pri ktorých je pozorovateľná elektromigrácia, sú v spájkovaných spojoch na úrovni 103–104 A.cm-2 pri použití spájok na základe Sn, Ag a Cu používaných v čipoch integrovaných obvodov. Elektromigrácia predstavuje riziko najmä pre spájkované spoje puzdier typu BGA, FLIP Chip alebo CSP vzhľadom na ich malé geometrické rozmery. Malé geometrické rozmery spôsobujú vysokú lokálnu prúdovú hustotu, tzv. hromadenie elektrónov (obr. 2).
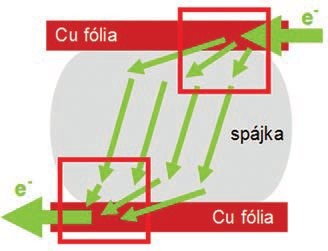
Obr. 2 Hromadenie elektrónov v spájkovanom spoji (červený rámček). Zelené šípky označujú smer toku elektrónov.
V spájkovaných spojoch s rozmermi na úrovni mm je omnoho nižšia prúdová hustota v dôsledku ich väčších geometrických rozmerov. Sú tu potrebné veľmi vysoké prúdy na dosiahnutie vysokej prúdovej hustoty, ktorá by spôsobovala elektromigráciu. Napriek tomu, že spájkované spoje vo výkonovej alebo automobilovej elektronike sú zaťažované vysokými prúdmi, nie je to taká vysoká prúdová hustota, ako napr. v malých spojoch pri puzdrách Flip Chip.
Ako príklad elektromigrácie sú v tomto článku uvedené spájkované spoje vytvorené pretavením spájkovacej pasty 96,5 Sn3Ag 0,5 Cu (hm. %) na Cu spájkovacej plôške dosky plošného spoja. Spoje s priemerom ~ 400 µm boli podrobené v priebehu 300 hodín starnutiu pri teplote 125 oC, prúdom 8 A, čo zodpovedá prúdovej hustote ~ 6400 A.cm-2. Vodivý motív na doske predstavoval zapojenie tzv. daisy chain, ktoré sa rozsiahlo využíva na meranie elektrického odporu štvorvodičovou metódou. Časť vzoriek bola vyhradená ako kontrolný súbor zaťažovaný rovnakým prúdom pri izbovej teplote. Zo skúšobného merania teploty počas prúdovej záťaže na povrchu dosky plošného spoja kontrolných vzoriek vyplýva, že v dôsledku vysokej prúdovej hustoty dochádza k ohrievaniu spájkovaných spojov a tým aj celej dosky na vyššiu teplotu, ako je izbová teplota. Maximálna teplota spojov počas zaťažovania bola 58 °C.
Pre následné pozorovanie mikroštruktúry spájkovaných spojov boli pripravené metalografické výbrusy (obr. 3). Na obr. 3a je znázornené rozhranie spájka a Cu spájkovacia plôška pred samotným starnutím. Ako vyplýva z obrázka, spájkovaný spoj vykazuje po spájkovaní homogénnu mikroštruktúru bez prítomnosti dutín či iných porúch. Na rozhraní Cu plôšky a spájky sa vytvorila intermetalická vrstva pozostávajúca z dvoch kryštalických fáz: Cu3Sn a Cu6Sn5 (hrúbka na úrovni 3–4 µm indikuje kvalitný spoj). Pri následnom starnutí pri zvýšenej teplote a prúde dochádza k vzniku dutín (rozmer 1–2 µm) na rozhraní spájka a Cu plôška už po 43 hodinách a k hrubnutiu intermetalickej vrstvy (hrúbka až 10 µm), obr. 3b. Ďalším starnutím sa rozmery dutín a hrúbka intermetalickej vrstvy zväčšujú, po uplynutí 300 hodín (obr. 3d) dochádza k vytvoreniu takmer súvislej trhliny (hrúbka až 10 µm) na rozhraní spájky a spájkovacej plôšky v oblasti intermetalickej vrstvy (hrúbka vrstvy až 20 µm). Teda možno jednoznačne konštatovať, že v dôsledku intenzívneho toku elektrónov v smere od spájkovacej plôšky do spájky dochádza k prenosu materiálu spájkovaného spoja. Tento prenos materiálu môže viesť až k úplnému oddeleniu spoja od dosky plošného spoja alebo súčiastky, teda k znefunkčneniu elektronického zariadenia. Hrubnutie intermetalickej vrstvy je v tomto prípade spôsobené najmä zvýšenou teplotou.
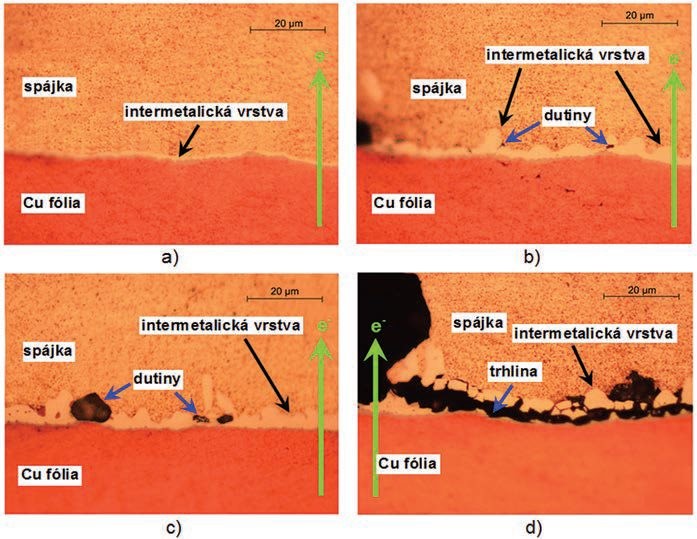
Obr. 3 Spájkované spoje zaťažované pri teplote 125 oC a prúde 8 A: a) 0, b) 43, c) 163 a d) 300 hodín.
Zelená šípka označuje smer toku elektrónov
Na kontrolných vzorkách zaťažovaných pri izbovej teplote dochádzalo rovnako k vzniku dutín, no v menšej miere, čo sa prejavilo menším nárastom elektrického odporu spojov v priebehu testu (obr. 5). Veľkosť vzniknutých dutín ovplyvňuje elektrický odpor spájkovaného spoja, pretože dochádza k zmenšeniu pracovného prierezu. Relatívna zmena odporu bola vypočítaná ako pomer aktuálneho odporu spoja a odporu na začiatku testovania (Rh/R0). Z pozorovaní výbrusov spájkovaných spojov možno konštatovať, že hlavným rozdielom medzi vzorkami zaťažovanými pri izbovej teplote (obr. 4) a vzorkami zaťažovanými pri zvýšenej teplote (obr. 3d) je hrúbka intermetalickej vrstvy. Zvýšená hrúbka intermetalickej vrstvy následne napomáha elektromigrácii, čo akceleruje tvorbu dutín a rozvoj následných porúch. Je potrebné zdôrazniť, že dutiny vznikali na miestach, kde vodivostné elektróny vstupovali do spájkovaného spoja. Teda materiál spájky bol transportovaný v smere toku elektrónov.
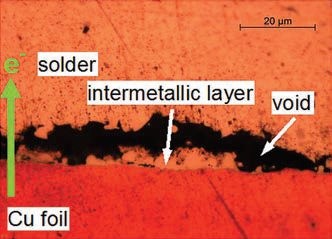
Obr. 4 Spájkovaný spoj zaťažovaný v priebehu 300 hodín prúdom 8 A pri izbovej teplote.
Zelená šípka označuje smer toku elektrónov.

Obr. 5 Relatívna zmena elektrického odporu spájkovaných spojov v priebehu testu
Elektromigrácia znamená premiestňovanie materiálu, v oblasti elektroniky najmä spájkovaného spoja v dôsledku zvýšeného namáhania jednosmerným prúdom. Je to degradačný jav spôsobený tokom elektrónov unášajúcich materiál spoja k anóde, v dôsledku čoho sa na strane katódy vytvárajú dutiny po chýbajúcom materiáli. Najbežnejšie sa prejavuje elektromigrácia tvorbou dutín a zvýšeným rastom intermetalických zlúčenín. Tento jav vzniká najmä na miestach, kde sa usporiadanie atómov v jednotlivých kryštalických fázach líši od ideálneho usporiadania. Kritická hranica prúdovej hustoty je na úrovni 103 –104 A.cm-2 pri použití spájok na základe Sn, Ag a Cu. Elektromigrácia môže znamenať až úplné prerušenie spájkovaného spoja, teda v konečnom dôsledku znefunkčnenie elektronického zariadenia. Ako vyplýva z našich experimentov (prúdová hustota ~ 6 400 A.cm-2, teplota 125 oC), čas 300 hodín je dostatočný na výrazné poškodenie spájkovaných spojov ohrozujúce samotnú funkčnosť elektronického zariadenia.
Literatúra:
[1] CHOI, J. Y.; LEE, S. S.; JOO, J. C.: Electromigration Behavior of Eutectic SnPb Solder, School of Materials Science & Engineering, Seoul National University, 2002.
[2] CHAO, B. H. L.; ZHANG, X.; CHAE, S. H.; HO, H. P.: Recent advances on kinetic analysis of electromigration enhanced intermetallic growth and damage formation in Pb-free solder joints, Microelectronics Reliability, roč. 49, č. 3, 2009, s. 253–263. http://www.csl.mete.metu.edu.tr
[3] DE ORIO, R. L.; CERIC, H.; SELBERHERR, S.: Physically based models of electromigration: From Black’s equation to modern TCAD models, Microelectronics Reliability, roč. 50, 2010, s. 775–789.