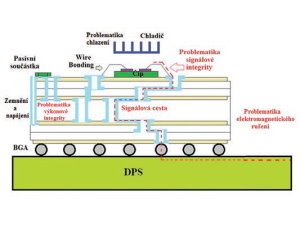
Pouzdření elektronických obvodů a systémů se stává jedním z rozhodujících fenoménů doby, který určuje nejen úroveň integrace daného celku, ale i jeho spolehlivost, kvalitu a také ekonomickou úspěšnost. Minula doba, kdy výrobci součástek chrlili nepřeberné množství diskrétních komponent, převážně v pouzdrech DIL, a uživatelé je osazovali na DPS. Výsledkem pak bylo uspořádání elektronického systému, kde jednotlivé funkce, jako vstupní a výstupní obvody, paměti, logické obvody, vysokofrekvenční obvody či řídicí obvody, byly tvořeny jako diskrétní části prezentované vlastními integrovanými obvody, z nichž každý obsahoval polovodičový čip určený pro příslušnou funkci (obr. 1). Postupem času vznikaly nové typy pouzder, jako např. QFP, BGA, QFN atd., která zpravidla obsahovala jeden polovodičový čip, což sice přineslo jistá zlepšení, avšak s určitými omezeními dosahovaných parametrů.
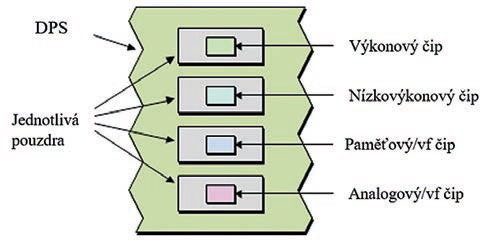
Obr. 1 Znázornění konfigurace s jednotlivě zapouzdřenými čipy
Taková řešení jsou sice přehledná a relativně snadno realizovatelná, ale mají celou řadu nevýhod a omezení. To vyvolává neustálou snahu hledat nová konstrukční řešení s cílem dosažení dalšího zlepšování, především v následujících oblastech, které lze označit jako nejvýznamnější faktory v inovaci elektronických sestav z pohledu pouzdření:
Jistým řešením vedoucím ke zlepšení uvedených faktorů jsou HIO a multičipové moduly (MCM). Hybridní integrované obvody jsou realizovány převážně na keramickém substrátu technologií tlustých nebo tenkých vrstev tvořících pasivní síť. Aktivní součástky jsou pak osazeny na substrát ve formě čipů a po jejich propojení je vše zapouzdřeno do jediného celku. Hybridní technologie dnes nachází uplatnění především v některých specifických oblastech, jako je senzorika, výkonové a vysokofrekvenční aplikace apod. U multičipových modulů se jedná o integraci více čipů do jednoho celku, případně pouzdra, což je přínosem zvláště pro řešení s digitálními obvody, kde našlo toto uspořádání nejčastější využití. DPS přitom zůstávají ve většině případů nosnou částí systému.
Snaha po co nejvyšší integraci vedla k umístění všech funkčních bloků na jeden polovodičový čip, což představuje SoC. Zde jsou na jediném čipu procesory, paměťové bloky, obvody vstupu a výstupu, řídicí obvody atd., tedy podstatná část celého elektronického systému.
Výhodou takového řešení je dosažení maximálního výkonu (z pohledu hodnocení výkonosti počítačů GIPS) a minimalizace spotřeby energie. Tak jako přináší každé nové řešení výhody, jsou zde ale i nevýhody, které spočívají především v technologické a časové náročnosti a také v omezené flexibilitě z hlediska aplikací a požadovaných modifikací. Lze zmínit i skutečnost, že realizace analogových funkcí na jediném čipu s digitálními obvody omezuje jejich optimální řešení, což se může promítnout jak do technologické realizace (izolace), tak do elektrických vlastností (přeslechy a rušení).
Počátky vzniku takového uspořádání lze hledat již v minulém století. Zde musím vzpomenout 70. léta, kdy jsme v Tesle Lanškroun vyvíjeli a realizovali pro různé oblasti aplikací HIO a MCM, včetně obvodů umístěných v keramických pouzdrech CC (Chip Carrier). Holé čipy osazené na pasivní síti nosného substrátu byly připojovány mikrodrátky ultrazvukovým kontaktováním. S vývojem a rozvojem nových materiálů, komponent a technologií se stala tato koncepce na počátku XXI. století jedním z určujících směrů v inovaci elektronických obvodů a systémů. K tomu přispěla i skutečnost, že se objevily nové aplikační možnosti, jako jsou MEMS, optoelektronické součástky atd.
Základní princip SiP spočívá v umístění více holých čipů na společném substrátu, který zajistí jejich vzájemné propojení. Připojení čipů může být provedeno buď mikrodrátky (dnes např. termosonicky), nebo s pomocí bumpů (např. Flip Chip). To vše pak tvoří jediné pouzdro, které lze připojit na DPS zavedenou technologií povrchové montáže. Základní pohled na konfiguraci SiP je na obr. 2.
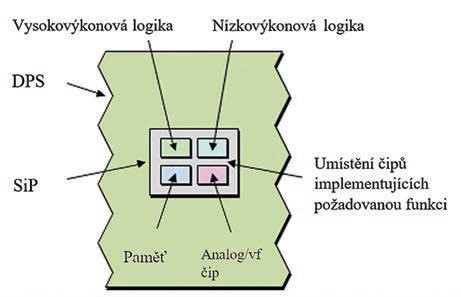
Obr. 2 Znázornění základní konfigurace pouzdření SiP
SiP poskytuje oproti SoC nesporně řadu výhod, jako je možnost výběru optimálního funkčního bloku pro jednotlivé části systému a větší flexibilita v modifikaci a doplňování nových funkcí. Je zde také možnost volit podle dané aplikace typ substrátu, který může být:
Oproti plošnému uspořádání 2D je v konfiguraci 2,5D umístěn mezi čipy a substrát pouzdra SiP křemíkový mezisubstrát (Interposer). Ten přes vytvořené průchody TSV a metalizační vrstvy na jeho spodní i horní straně propojuje čipy na něm umístěné se základním substrátem pouzdra, jak je patrné z obr. 3. Zde jsou pro jednoduchost znázorněny dva komponenty Flip Chip s kuličkovými vývody 100 μm i méně. Funkcí mezisubstrátu je adaptovat rozdíl připojovací struktury čipů (řádově μm až nm) na možnosti DPS s využitím standardních metod povrchové montáže a eliminovat termomechanické namáhání mezi čipy a DPS, jež mají rozdílnou tepelnou roztažnost.
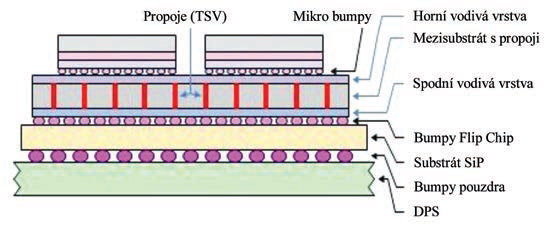
Obr. 3 Znázornění 2,5D SiP s křemíkovým mezisubstrátem a dvěma Flip Chip
Výhodou použití technologie 2,5D je oproti konstrukcím v uspořádání 2D podstatné zvýšení výkonu a samozřejmě vyšší stupeň integrace. Hlavní nevýhoda spočívá v tom, že je nezbytné ke konstrukci takového provedení mít příslušné technologické vybavení.
Pokud se umístí více čipů na sebe v ose z, vzniká SiP v uspořádání 3D. Teoreticky lze takto montovat více čipů jeden na druhý, vzhledem k jejich malé tloušťce (řádově stovky μm), avšak to je omezeno vznikem tepla, které je třeba odvádět. U konstrukcí 3D existuje celá řada různých provedení, z nichž jedno je na obr. 4. Zde jsou v jediném pouzdře umístěny jak Flip Chip, tak holý čip připojený mikrodrátky.
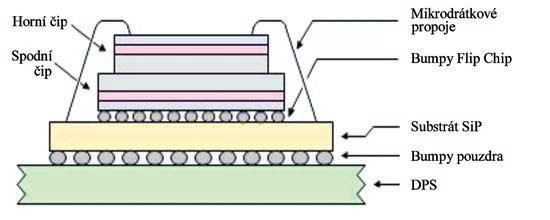
Obr. 4 Znázornění jedné z možných variant pouzdra 3D
Takových čipů může být montováno a propojeno několik a pak lze realizovat celý elektronický systém nebo jeho podstatnou část v jediném pouzdře.
Pod tímto pojmem si lze představit vysoce miniaturizovanou systémovou technologii, která slučuje co nejvíce funkcí (výpočetních, komunikačních, spotřebitelských apod.) do jediného pouzdra. Cílem je jednak další omezování negativně působících faktorů limitujících zvyšování pracovních kmitočtů, zajištění odvodu tepla a dalších elektrických a mechanických parametrů, ale také umožnění systémové integrace mikrovlnných, optických a dalších komponent do jediného pouzdra. Na obr. 5a je naznačen zjednodušený pohled na některé oblasti, v kterých je SoP přínosem, na obr. 5b potom celkový demonstrativní pohled na možnou strukturu pouzdra SoP v řezu.
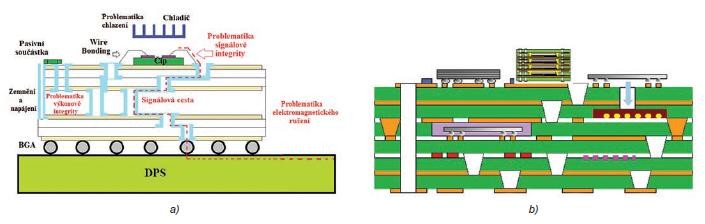
Obr. 5 Příklad pouzdra SoP: a) detailní znázornění některých řešených problémů, b) pohled na možné uspořádání
Označení SiP, SoP a další bývá výrobci obvodů různě zaměňováno a spojováno a může se více či méně lišit. Skutečností je, že s nástupem integrace 3D vzniká celá řada nových konstrukcí. K tomu přispívá také vývoj vícevrstvých DPS nebo nových možností technologie nízkoteplotní keramiky (LTCC), které umožňují montáž vnořených (Embeded) součástek. DPS nebo LTCC substrát se tak stává nedílnou součástí pouzdra. Tak například zapouzdříme-li několik malých SiP do jednoho nedělitelného celku, bývá toto označováno jako PiP (Package in Package) nebo PoP (Package on Package). Zde prozatím jednotná terminologie neexistuje. Podstatná je skutečnost, že cesta inovace v podobě zlepšování parametrů, včetně spolehlivosti elektronických systémů, vede přes zavádění nových materiálů a technologií, přičemž pouzdření je nedílnou a určující částí celého elektronického systému. To vyžaduje stále intenzivnější spolupráci a součinnost mezi dodavateli součástek, materiálů, technologických zařízení a finálními výrobci. A právě to je jedním z poslání Mezinárodní společnosti pro mikroelektroniku a pouzdření (IMAPS).
www.imapseurope.org, www.imaps.org
szend@vutbr.cz